1. 飛行時間二次離子質譜技術
二次離子質譜技術(Dynamic Secondary Ion Mass Spectrometry,D-SIMS)是一種非常靈敏的表面分析技術,通過用一次離子激發樣品表面,打出極其微量的二次離子,根據二次離子的質量來測定元素種類,具有極高分辨率和檢出限的表面分析技術。D-SIMS可以提供表面,薄膜,界面以至于三維樣品的元素結構信息,其特點在二次離子來自表面單個原子層(1nm以內),僅帶出表面的化學信息,具有分析區域小、分析深度淺和檢出限高的特點,廣泛應用于物理,化學,微電子,生物,制藥,空間分析等工業和研究方面。
2. 動態二次離子質譜分析(D-SIMS)可為客戶解決的產品質量問題
(1)當產品表面存在微小的異物,而常規的成分測試方法無法準確對異物進行定性定量分析,可選擇D-SIMS進行分析,D-SIMS能分析10nm直徑的異物成分。
(2)當產品表面膜層太薄,無法使用常規測試進行膜厚測量,可選擇D-SIMS進行分析,利用D-SIMS測量1nm的超薄膜厚。
(3)當產品表面有多層薄膜,需測量各層膜厚及成分,利用D-SIMS能準確測定各層薄膜厚度及組成成分。
(4)當膜層與基材截面出現分層等問題,但是未能觀察到明顯的異物痕跡,可使用D-SIMS分析表面超痕量物質成分,以確定截面是否存在外來污染,檢出限高達ppb級別。
(5)摻雜工藝中,摻雜元素的含量一般是在ppm-ppb之間,且深度可達幾十微米,使用常規手段無法準確測試摻雜元素從表面到心部的濃度分布,利用D-SIMS可以完成這方面參數測試。
3. 動態二次離子質譜分析(D-SIMS)注意事項
(1)樣品最大規格尺寸為1cm,1cm,0.5cm,當樣品尺寸過大需切割取樣,樣品表面必須平整。
(2)取樣的時候避免手和取樣工具接觸到需要測試的位置,取下樣品后使用真空包裝或其他能隔離外界環境的包裝, 避免外來污染影響分析結果。
(3)D-SIMS測試的樣品不受導電性的限制,絕緣的樣品也可以測試。
(4)D-SIMS元素分析范圍H-U,檢出限ppb級別。
4.應用實例
樣品信息:P92鋼陽極氧化膜厚度分析。
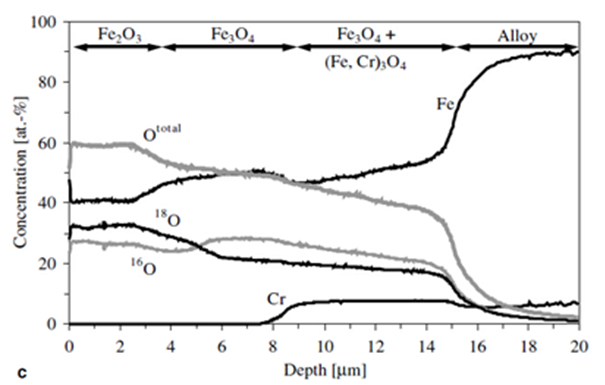
分析結果:氧化膜厚度為20nm,從表面往心部成分分布:0-4nmFe2O3,4-9nmFe3O4,9-15nm(Fe.Cr)3O4,15-20nm合金化混合區。

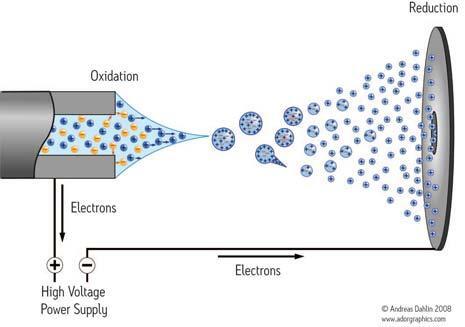







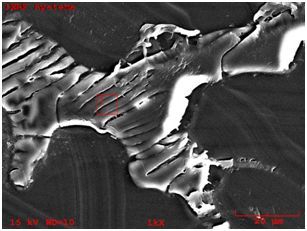







.jpg)
